
東大ら4機関、DUVレーザーで半導体基板に世界最小の穴あけ加工を実現
発表日:2024年5月31日
概要
東京大学、味の素ファインテクノ株式会社、三菱電機株式会社、スペクトロニクス株式会社の4機関は、次世代半導体基板加工技術として不可欠な、深紫外(DUV)レーザー加工機を用いた層間絶縁膜への直径3マイクロメートルの微細穴あけ加工を実現しました。
現在チップ実装基板の層間配線として用いられているのは、直径40マイクロメートル穴であり、一桁小さい微細穴あけ加工技術の実現は、半導体実装基板の高密度化へ貢献します。
半導体後工程におけるレーザー微細穴あけ加工技術の向上により、次世代チップレットの高機能化が期待されます。
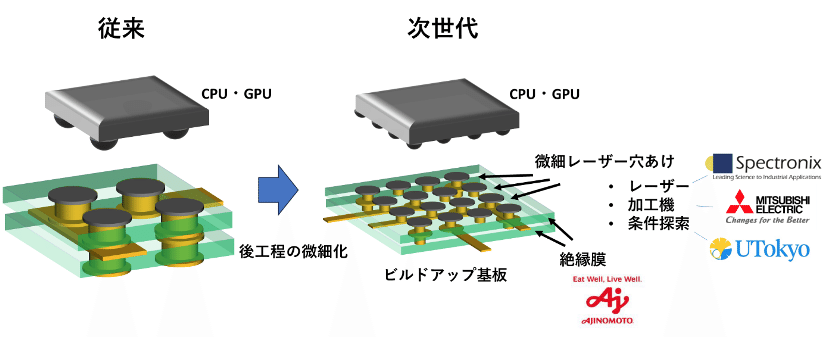
発表の背景
近年、EUV露光技術の発展により半導体チップの微細化が進み、チップの電極間隔も小さくなっています。それに伴い、チップを受ける側のパッケージ基板の配線も微細化が進んでいます。基板は多層構造であり、層間の電気信号は絶縁層にあけられた微小な穴を通して結合されます。
現在は40マイクロメートル程度の穴をレーザーであけて金属メッキを施すことで層間配線を行っていますが、チップの微細化に伴い将来はパッケージ基板の穴径が5マイクロメートル以下の微細化が必要とされています。
しかし、現在用いられているレーザー加工技術では、レーザーや光学系の特性で小さい径に集光することが困難であり、また高いアスペクト比の穴あけ加工はできないという問題があります。さらに、これに対応する微細穴あけ加工に適した薄い絶縁層も必要です。
このように、次世代の半導体チップの微細化に対応するためには、パッケージ基板の微細化技術のさらなる進展が求められています。

発表の内容
本研究開発チームはTACMIコンソーシアムにおいて、レーザー開発、加工機開発、材料開発およびパラメータ探索を得意とする4法人が技術を持ち寄ることで、半導体向けの層間絶縁体として高いシェアを占める味の素ビルドアップフィルム(ABF)に3マイクロメートルの超微細穴あけ加工を実現しました。
まず、東京大学はガラス基板上に銅を蒸着し、レーザー加工で銅をパターン状に削り取り、微細な銅の配線を作成しました。次に、味の素ファインテクノがこの銅配線層上に薄膜ABFを積層し、銅上に3マイクロメートルの絶縁層を形成しました(図1左)。
スペクトロニクスは波長266ナノメートルのDUV高出力レーザーを担当し、三菱電機は深紫外線用に特別に開発したレーザー加工機の光学系を改良し、集光サイズを従来よりも小さくしました。さらに、東京大学はAIを活用した条件探索を行い、エッチング技術を使わずにレーザー加工のみで3マイクロメートル直径の穴をABF上に作成しました(図1右および図2右)。図2右をみると、ABFにのみ穴が開き、下の銅配線やガラスは削れていないことが確認できます。
この技術により、自由な穴あけパターンを基板上に高速に作成することが可能となります。
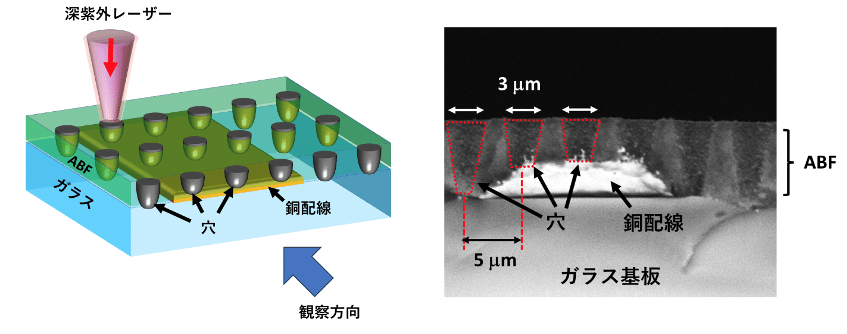
今後の展望
本成果は、半導体業界における後工程ロードマップの重要なマイルストーンとなります。レーザー加工機で次世代の微細穴あけ加工が可能であることを示したことで、半導体のさらなる微細化において低コストで自由度の高い基板加工が可能であることが明らかになりました。
今後は、さらなる微細化に取り組むとともに、複雑化するチップレットの製造工程における技術課題についても、レーザー加工で対応可能な範囲を拡大するための研究・技術開発を進めていきます。また、産業応用については、大手半導体メーカーなどに対し、本技術の周知を進める方針です。
この技術の進展により、半導体製造プロセスの効率化が期待され、業界全体に対して大きな影響を与える可能性があります。
参考文献
おすすめ記事
#半導体 #半導体関連 #半導体株 #半導体って何 #半導体の基礎
#注目ニュース #ニュース #半導体ニュース #最新ニュース
# スキしてみて
よろしければサポートもよろしくお願いいたします.頂いたサポートは主に今後の書評執筆用のために使わせていただきます!
