
EUVペリクルの話題をざっくり解説
EUVネタで主役とはならないまでも、それなりの頻度で現れる「EUVペリクル」に関する話題。難しいところに深入りせず、記事トピックスを見て「ああ、このことを言ってるんだな」とざっくり把握できるくらいにトピックスまとめてみました。ご拝受ください。
※随時アップデートするかもしれません。

EUVマスク用ペリクルのトピックス
■ そもそもEUVマスクにペリクルいるんか?問題
EUV黎明期からの基本的なトピックです。まずはおさらい。
DUVまで、マスクとペリクルは「ワンセット」でした。マスクパターンに対して、いわゆる投影露光での露光解像しない(デフォーカスする)距離に膜を張ったものがペリクルです。
下の写真(AGCさんから拝借)で片方しかないのは、マスクのガラス厚み(0.25inch)のおかげで、マスクパターン描画をしている面の逆側(この写真では下面)に異物が付着してもデフォーカスして解像されないため、片方でOKという理由です。もちろん顕著な傷や汚れはNGです。

そしてEUVマスク用のペリクルについて。
まずEUV光の透過に対する技術問題は立ちはだかりつつ、EUVならではの異物・デブリ対策のため、黎明期は「まあ必要だよね・・・」ということで研究がすすめられます。ただ透過率そのものや後述する負荷に対する問題のため、思うような性能まで得られていないのがここのところまでの話でした。
TSMCがEUV立ち上げて間もなく「ドライクリーニング技術」をマスク異物にも適用することで、EUVマスクのペリクルレスを実現できたとの報道があり、ほへーと感心しておりました。
ただ2021年の別記事では「TSMC、EUV用内製ペリクルのキャパを拡大」ということも書かれています。ペリクルなしの運用じたいはおそらく本当であるにしろ、ドライクリーニングは一部適用のみで、実際はペリクル付き&寿命管理で運用しているのではないか?と推察してます。
(※定かではありません、もうちょっと追っていきたい)。
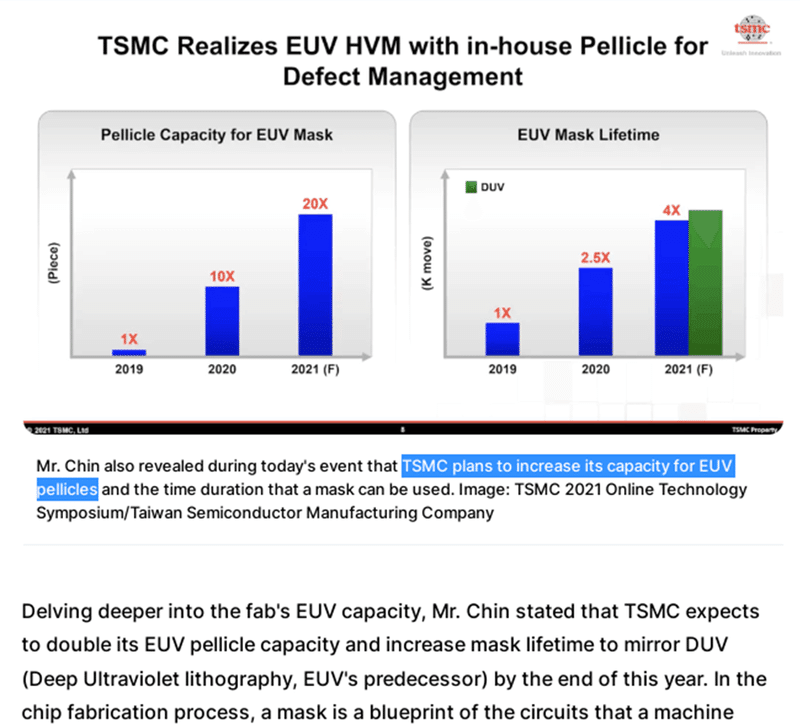
また、この1年ほどは歩留りの話題としてSamsungがよく挙げられていますが、こちらは現場としてペリクルがないと安定歩留りは達成できない、との判断の舵を切ったものと思われます。
■ ペリクル膜質(透過率)問題
ペリクル膜質に関わるパラメータはほぼすべてトレードオフなのですが、ここでは透過率についてかいつまんで。
まず透過率は2023年現在でやっと90%が見えてきた状況です。現在主流はASMLが開発したポリシリコン製(50nm厚)。三井化学が製造を請け負うことも2021年に報道されました。

また直近のトピックスとしてはカーボンナノチューブ(CNT)を用いたペリクルをimecが開発しており、透過率97%、かつ非常に高いソースパワー(1000W以上)に耐えることができます。 欠点はとしてはEUV光により炭素が水素ガスと反応して使用とともにペリクルが徐々に薄くなることです。信頼性とともに装置内の除塵なども考慮しなければならず、まだ研究開発段階と考えた方がよさそうです。

■ ペリクルのせいでマスク欠陥検査できない問題
ペリクルは接着剤で枠ごとガラスマスク上に貼りつけます。そしてマスクの最終欠陥検査は、ペリクル貼り付け作業が終わった後、が通常です(ちなみに貼り付け前もやります)。きれいなマスクでもペリクル貼った時に傷や異物が付いたら元の子もありませんから。
ところが当初、EUV光用のペリクル膜越しにマスクパターン欠陥を測る技術がありませんでした。これまでのDUV用の検査機では膜が不透明となってしまい中が見えない。これはマスク製造としては致命的。
第一の解決策は「いちいちペリクル外して測ればいいんじゃない?」手法。これまではペリクルを外すのは洗浄や破損時に限られている常識を崩し、取り外し可能なペリクルをASMLが開発しました。装置がオートでしてくれるので、まあ運用できそうといえばできそう。

第二の解決策、「EUV光で測っちゃえばいいじゃん!」手法。これが現在での最適解となっており、日本が誇るレーザーテック社がシェア100%を握っています。さすがの技術力。EUV用のペリクルあり・なし双方のマスク欠陥検査、EUV用ブランクス検査等々、すでにEUVプロセスのインフラになっています。

■ ペリクルへの負荷問題
透過率が90%にとどまっているということは、その分吸収がまだまだ存在しているということです。つまり、光負荷に対して相当の耐久性が必要となります。13.5nmという高エネルギー光を1日に数万回さらされつづけても膜質を維持し続ける必要があります。この熱は600-1000度に達します。局所的とはいえピザ釜(500度くらい)よりも熱い。。

一度上昇した熱はmsec単位で放熱をし、それを繰り返すことになります。装置側での排熱機能も当然としても、ペリクル膜・ペリクル枠の放熱性も重要ファクターになってきます。
ASMLの量産機 NXE3600Eの最大スループットは160枚/時で、1枚に100ショットあるとすると、一日に約40万回のショットが繰り返されることになります(同一マスクが使われ続けることはありませんが、、)このような量産使用時の負荷に対して耐えきれるか。
もうひとつ、EUVは反射光学系、DUVやi線は透過光学系です。すこし見過ごされがちなのが、一回の露光に対してEUVの場合は ペリクルに2回光が通ります。それゆえにベースとしての負荷が大きい状況にあること、これもいままでにないペリクル負荷の要因です。
■ 新世代のEUV機(NA=0.55)対応問題
問題というほどのものではないかもしれませんが、一応挙げておきます。
現在のEUV量産機であるNA=0.33と、2025年あたりから量産化されると目されるNA=0.55では、マスク運用で大きく変わる点があります。(※要キャッチアップ)
マスク倍率が、4倍ではなくなることです。
ややこしいことにヨコが4倍・タテが8倍になります。
正確に言うと、ウェハーでの所望の実パターンに対し、マスク上は幅方向は4倍サイズで変わらないが、スキャン方向は8倍サイズにするということです。これは露光機工学系の設計上の困難さを、マスク設計側で解決しようとした結果です。これで何が起きるかというと、ウェハーに転写することができる最大ショットサイズが半分になってしまいます。つまりショット数が純粋に倍になります。
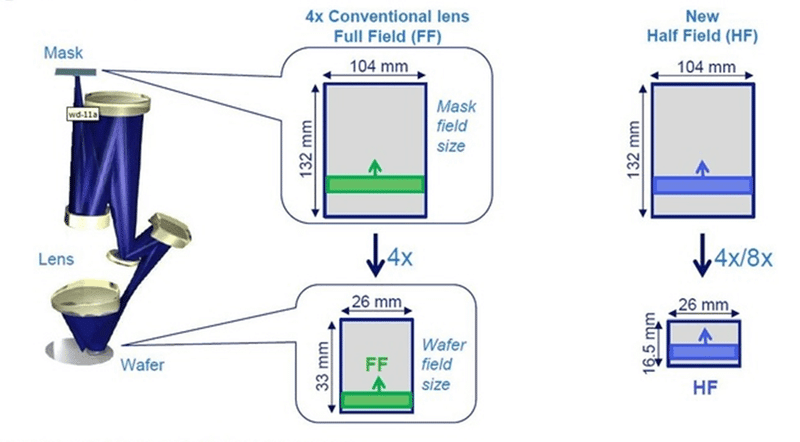
よって、ペリクルに対するEUV光の負荷も倍になってしまいます。一度の露光の時間的負荷は短くなるものの、劣化は連続的な負荷と非連続負荷での疲労の掛け合わせなため、後者に対してのケアが必要になります。
当然High NA型はクリティカルレイヤーに使うので、このあたりの膜質劣化もシミュレーションしていかないといけないんだろうなと、気が遠くなります。。
おわりに
研究開発関連の報道・プレスリリースでは判断しきれないものの、現在の歩留まり確保においては「やっぱペリクルつけなきゃね」の流れがスタンダードになるのでは、と思います。
ペリクルはケミカルからマスク面を守るという側面もあるので、一気のヘイズが生じることを避けるなどのメリットも考えられます。マスクそのものが非常に高価なので。。
この件は引き続き追っていきたいなとおもいます。
いったんおしまい。
この記事が気に入ったらサポートをしてみませんか?
